EMC NH-860 Overview
Resonac Corporation is one of the top providers of Epoxy Molding Compound (EMC) for semiconductor industry, with more than 30 years’ experience. In Malaysia, we have 2 manufacturing sites and 1 R&D facility to support our local as well as world-wide customers. With the growing Automotive industry, semiconductor packaging has become increasingly challenging with requirement to meet AEC-Q100 Grade0 MSL1 standard and beyond. Resonac Corporation is developing new EMC to meet this challenge – NH-860 series. It is designed with low modulus and high adhesion strength to prevent delamination, and thus improving package reliability. NH-860 series meets good MSL and package reability performance with non-roughened QFN package.
In addition, NH-860 series enables semiconductor package leadframe to switch from roughened to non-roughened surface. Thus, it has good potential for overall package cost down.
Join us in this journey towards AEC-Q100 and beyond.
Performance
Through internal evaluation, NH-860K2 can meet good MSL performance for QFN and SOP packages as shown in table below.
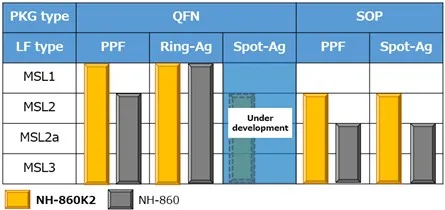 |
Note: all leadframes are non-roughened.
Note: NH-860K2 is improvement from NH-860 which is the initial development item.
By using NH-860K2, it enables package cost reduction by changing leadframe (or lead-frame) from roughened to non-roughened surface.
 |
NH-860 has low modulus and high adhesion properties to prevent delamination.


| Properties | Unit | Mass Production EMC1 | NH-860K2 |
| Tg | °C | 102 | 100 |
| Specific Gravity | – | 2.00 | 1.99 |
| CTE, α1 | ppm/°C | 10 | 9 |
| CTE, α2 | ppm/°C | 31 | 34 |
| Flexural Modulus (Room Temp.) | GN/m2 | 28 | 27 |
| Flexural Modulus (260°C) | MN/m2 | 530 | 290 |
| Ag adhesion (Room Temp.) | MPa | 7.9 | 8.4 |
| Ag adhesion (260°C with soaking) | MPa | 0.4 | 0.3 |
| PDF adhesion (Room Temp.) | MPa | 6.2 | 8.9 |
| PDF adhesion (260°C with soaking) | MPa | 0.1 | 0.4 |
Refer to table above, NH-860K2 has lower modulus and higher adhesion strength to prevent delamination.
NH-860K2 Passed MSL1 with Zero Delamination

Non-roughened PPF QFN package

Non-roughened ring-AgCu QFN package
PKG size : 10 x 10mm
Die pad size : 6.4 x 6.4mm
Die size : 3 x 3 x 0.37mm
NH-860K2 Passed Continuous Molding 600 Shots
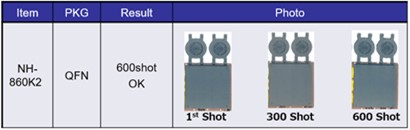
Achieve CTI 600V based on internal evaluation (based on IEC60112)
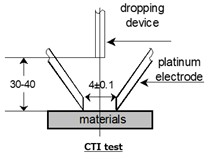
| CTI Test | |
| Drop Volume | 0.997 – 1.147g for 50 drops |
| Drop height | 35 ± 5mm |
| Electrolyte | Ammonium chloride solution (0.1±0.02%) |
| Drop interval | 30±5s |
| Short-circuit criterion | >0.5A for 2s |
| EMC Thickness | 3mm |
| Insulating Material Group |
CTI | |
| I | 600 ≤ CTI | NH-860K2 |
| II | 400 ≤ CTI < 600 | |
| IIIa | 175 ≤ CTI < 400 (FR4) | |
| IIIb | 100 ≤ CTI < 175 |
Achieve AEC-Q100 Grade 0 Requirement
(1) NH-860K2 pass TC 2000 cycles (-55°C to 150°C) on non-roughened PPF SO-28L leadframe.

(2) NH-860K2 pass HTSL 2000 hours (175°C) on non-roughened PPF SO-28L leadframe.

(3) NH-860K2 pass b-HAST 192 hours (130°C/85%RH/5V) on non-roughened PPF SO-28L leadframe.

Datasheet
For more information, kindly refer to Datasheet below.
| Kindly click the following links below to start your download. |